การวิเคราะห์การขึ้นรูป IC Packaging ขั้นสูง
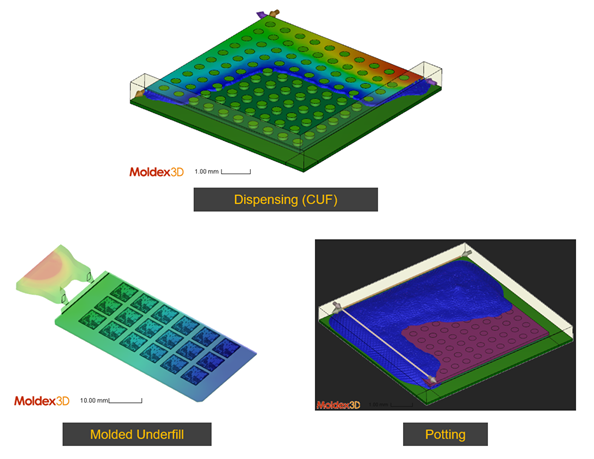
การห่อหุ้มชิปพลาสติก (Plastic chip encapsulation) เป็นกระบวนการขึ้นรูปโดยที่ชิปจะถูกหุ้มด้วยสารประกอบการขึ้นรูปแบบอีพ็อกซี่ (EMC) เพื่อป้องกันความเสียหายทางกายภาพหรือการกัดกร่อน ข้อบกพร่องที่พบบ่อย ได้แก่ การเติมไม่สมบูรณ์ ฟองอากาศสะสม ช่องว่างในชิ้นงานและการบิดงอของบรรจุภัณฑ์ เป็นต้น
Moldex3D IC Packaging ช่วยให้นักออกแบบสามารถวิเคราะห์กระบวนการห่อหุ้มชิปได้อย่างเต็มที่ ตั้งแต่การบรรจุ การบ่ม การทำความเย็น ไปจนถึงความต้องการขั้นสูงในการผลิต เช่น ความเข้มข้นของสารตัวเติม การห่อหุ้มที่น้อยเกินไป การบ่มภายหลังการขึ้นรูป การกระจายความเค้น หรือการประเมินโครงสร้าง ปัญหาการขึ้นรูปที่สำคัญสามารถคาดการณ์และแก้ไขได้ล่วงหน้า ซึ่งช่วยให้วิศวกรปรับปรุงคุณภาพเศษและป้องกันข้อบกพร่องที่อาจเกิดขึ้นได้อย่างมีประสิทธิภาพมากขึ้น การจำลองที่แม่นยำยังช่วยเพิ่มประสิทธิภาพการออกแบบและการจัดการต้นทุนที่ดี
สิ่งที่คุณจะได้เรียนรู้
- มีอะไรใหม่ใน Moldex3D 2021 IC Packaging
- ฟังก์ชัน IC Packaging และการตีความผลลัพธ์
- ข้อดีของ Moldex3D IC Packaging