IC Packaging
Encapsulation Innovation
Plastic Chip Encapsulation is a molding process where chips are being capsulated with Epoxy Molding Compound (EMC) or Liquid Molding Compound (LMC) to prevent physical damage or corrosion. This process contains the interconnection between microchips and other electronics (so-called wire bonding), curing phenomenon of thermoset material, and various control management of process conditions. Due to the complexity of multiple material components, many challenges and uncertainty have been brought to the Chip Encapsulation process. Common defects include incomplete fill, air traps, voids, wire sweep, paddle shift, package warpage, etc.
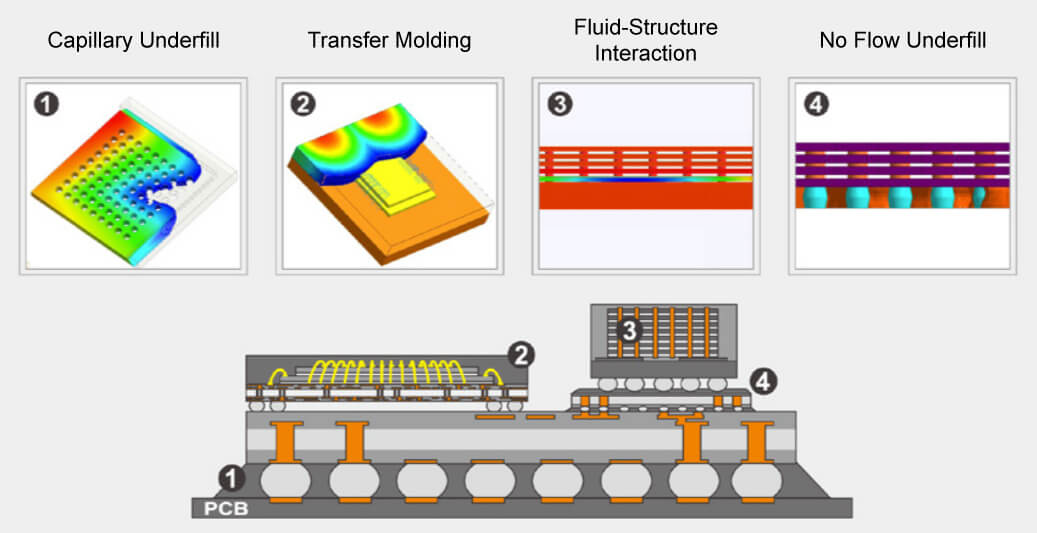
What Moldex3D Can Do
Moldex3D IC Packaging helps chip designers to fully analyze the chip encapsulation process from filling, curing, cooling, to advanced manufacturing demands, such as wire sweep, die shift, filler concentration, underfill encapsulation, post-molding curing, stress distribution, or structural evaluation. Significant molding problems can be predicted and solved upfront, which helps engineers enhance chip quality and prevent potential defects more efficiently. The accurate simulation also helps design optimization and well cost management.
Evaluate Chip Layout with Flow Pattern
- Gate and runner design evaluation
- Chip layout & Flow balance optimization
- Air trap prediction

Structure Validation
- Wire sweep, chip deformation and paddle/die shift prediction via fluid-structure interaction
- Structural performance co-simulate with ANSYS and Abaqus
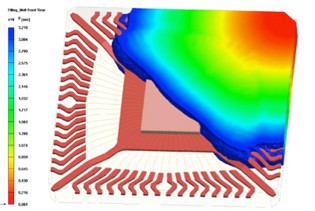 |
 |
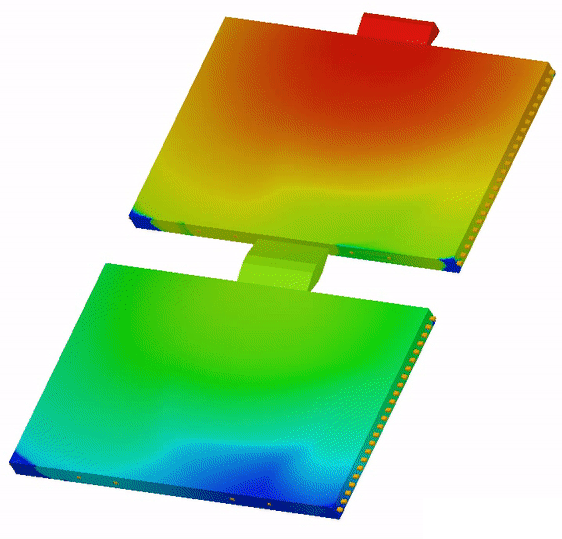 |
Predict the Effects of Process Variation
- Production simulation based on real processes condition
- Predict warpage based on material property and process
- Temperature, conversion and stress distribution are visualized
 |
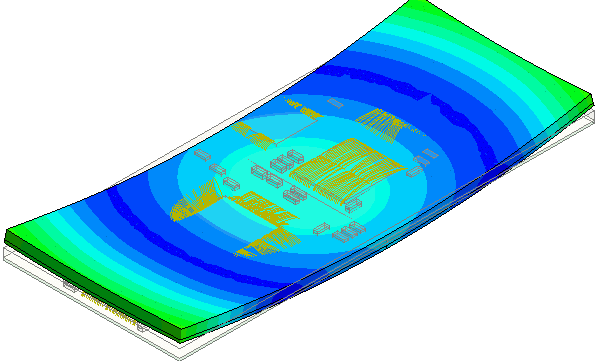 |
Post Mold Cure Warpage Simulation
- Visualize stress relaxation and chemical shrinkage
- Predict deformation with post mold cure process via temperature, conversion and stress distributions simulation

Advanced Material Property Measurement for Accurate Simulation
- Measure curing kinetics, viscosity, viscoelastic properties for flow simulation
- Determine viscoelasticity stress relaxation, chemical shrinkage and thermal expansion effect for warpage prediction
 |
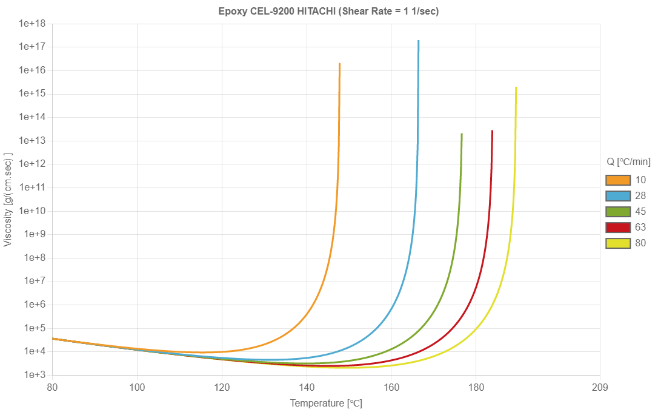 |
Moldex3D provides specific process solutions for IC packaging.
Transfer Molding & Molded Underfill Simulation
- Optimize the gate and runner designs and Visualize filling and curing processes
- Predict potential molding defects like void location and short shot
- Calculate the pressure drop inside the air zone to optimize the air vent design
- Evaluate the process conditions and material properties to reduce cycle time
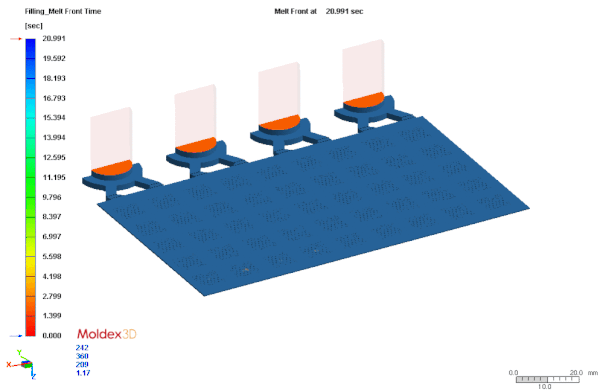
Compression Molding & Embedded Wafer Level Packaging Simulation
- Visualize dynamic melt flow front during compression molding process
- Evaluate warpage, shear stress distribution and die shift for Fan-out package
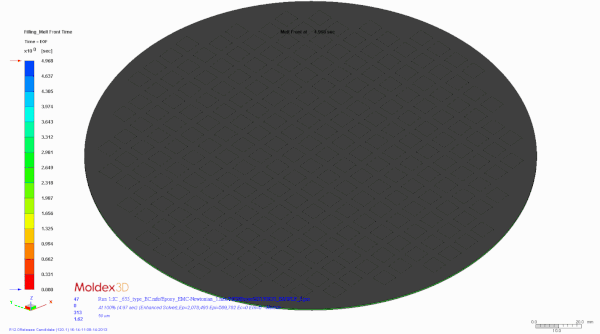
Capillary Underfill Simulation
- Visualize capillary-force-induced filling behavior with different surface tension and contact angle
- Evaluate the flow effects due to bump pitch and bump pattern
- Optimize the dispensing setting for capillary Underfill process
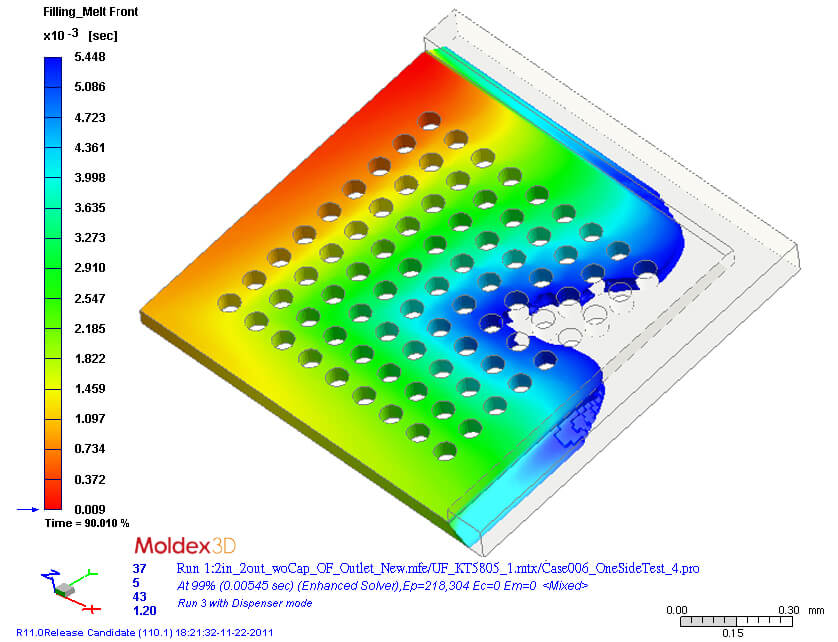 |
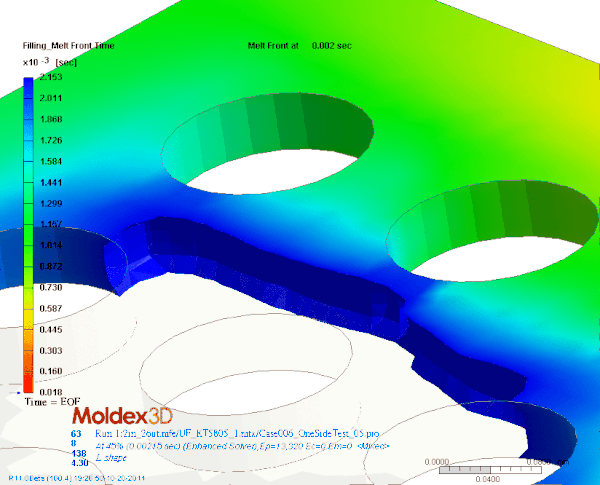 |
Potting
- More realistic and detailed visualization of dispenser pass and feeding (potting & dotting)
- Full physical model applied to simulate surface tension induced behaviors such as creeping
- User-friendly modeling tools and setting UI for a variety of process designs