- Date:Jan 19, 2022
- Location: Thailand
- Time: 10:00 AM GMT+7

10:00 น. เวลาประเทศไทย | วันพุธที่ 19 มกราคม 2565
การห่อหุ้มชิปพลาสติก (Plastic chip encapsulation) เป็นกระบวนการขึ้นรูปโดยที่ชิปจะถูกหุ้มด้วยสารประกอบการขึ้นรูปแบบอีพ็อกซี่ (EMC) เพื่อป้องกันความเสียหายทางกายภาพหรือการกัดกร่อน ข้อบกพร่องที่พบบ่อย ได้แก่ การเติมไม่สมบูรณ์ ฟองอากาศสะสม ช่องว่างในชิ้นงานและการบิดงอของบรรจุภัณฑ์ เป็นต้น
Moldex3D IC Packaging ช่วยให้นักออกแบบสามารถวิเคราะห์กระบวนการห่อหุ้มชิปได้อย่างเต็มที่ ตั้งแต่การบรรจุ การบ่ม การทำความเย็น ไปจนถึงความต้องการขั้นสูงในการผลิต เช่น ความเข้มข้นของสารตัวเติม การห่อหุ้มที่น้อยเกินไป การบ่มภายหลังการขึ้นรูป การกระจายความเค้น หรือการประเมินโครงสร้าง ปัญหาการขึ้นรูปที่สำคัญสามารถคาดการณ์และแก้ไขได้ล่วงหน้า ซึ่งช่วยให้วิศวกรปรับปรุงคุณภาพเศษและป้องกันข้อบกพร่องที่อาจเกิดขึ้นได้อย่างมีประสิทธิภาพมากขึ้น การจำลองที่แม่นยำยังช่วยเพิ่มประสิทธิภาพการออกแบบและการจัดการต้นทุนที่ดี
สิ่งที่คุณจะได้เรียนรู้
- มีอะไรใหม่ใน Moldex3D 2021 IC Packaging
- ฟังก์ชัน IC Packaging และการตีความผลลัพธ์
- ข้อดีของ Moldex3D IC Packaging
Advanced IC Package Simulation in Moldex3D
Plastic chip encapsulation is a molding process where chips are being capsulated with epoxy molding compound (EMC) to prevent physical damage or corrosion. Common defects include incomplete fill, air traps, voids, wire sweep, paddle shift, package warpage, etc.
Moldex3D IC Packaging Simulation helps designers to fully analyze the chip encapsulation process from filling, curing, cooling, to advanced manufacturing requirements, such as filler concentration, underfill encapsulation, post-molding curing, stress distribution, and structural evaluation. Significant molding problems can be predicted and solved upfront, helping engineers enhance chip quality and prevent potential defects more efficiently.
What You Will Learn
- What’s New in Moldex3D 2021 IC Packaging
- IC Packaging functionality and result interpretation
- The advantage of Moldex3D IC Packaging
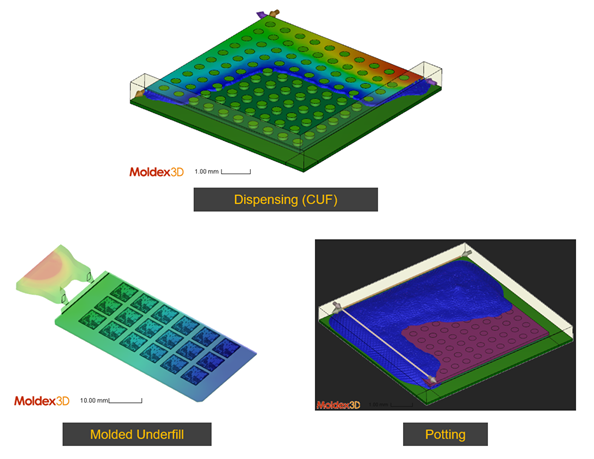
Contact
คุณปรัชญาพร พลวริษฐ์กูล
โทรศัพท์: +66 (0) 2-276-2880
แฟกซ์: +66 (0) -2-276-2882