IC Insights’ 2012 McClean보고서에 따르면, IC의 조립 및 패키지는 더 이상 front-end공정에 밀려 뒷자리를 차지하지 않는다. 패키지는 단순한 cookie-cutter형 패키지에서 고도로 정교한 주문자 맞춤 형식의 솔루션으로 진화하였다. 아마도 이것이 반도체 제조사들이 패키지 시장에 뛰어들기를 원하는 최근 산업 트랜드를 반영하고 있으며, 3D IC의 인기가 증가됨에 따라 패키징에 대한 자본 지출은 해가 갈수록 늘어날 것으로 예상된다.
현재 반도체 제조 공장에서는 웨이퍼레벨 패키징 기술로 인해 가져온 혜택으로 3D IC 공정에 상당한 자원과 연구를 투자해왔다. 전통적인 반도체 소자 조립 회사들도 역시 마이크로칩에 대한 거대한 글로벌한 수요에 따라 3D IC 공정에 집중하고 있다. 3D IC는 칩 성능과 기능 상승, 낮은 전력 소비, 더 큰 용량, 더 많은 대역폭과 칩 크기의 감소 등과 같은 우수한 기능을 제공하고 있다. 그렇지만, 이 과정은 열 및 안정성 문제를 극복해야 한다. 예를 들어, IC encapsulation 기술 내에 실리콘칩과 솔리드범퍼, 와이어본드, 리드 프레임, 패들 등을 보호하기 위해 사용되는 에폭시 몰딩 컴파운드가 구조적인 변형과 원치않는 결함을 이끌어낼 수 있다.
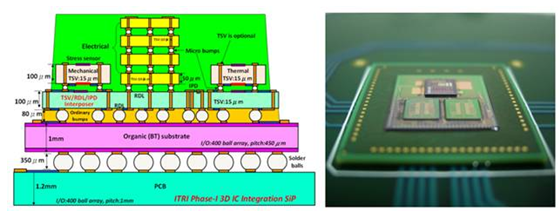 그림 1. 3D IC 구조의 조감도. Image source : ITRI, Electronics and Optoelectronics Research Laboratories.
그림 1. 3D IC 구조의 조감도. Image source : ITRI, Electronics and Optoelectronics Research Laboratories.
Moldex3D는 여러 해 동안 실제 IC encapsulation 공정에 많은 솔루션을 개발하여 제공하고 있다. Moldex3D Encapsulation solution은 와이어 스윕과 잔류 응력, 기공 등에 대한 정확한 예측을 제공한다. 3D IC 패키징 산업의 요구가 증가함에 따라, Moldex3D는 패키징 단계에서의 3D IC 신뢰성을 조사하기 위한 강력한 도구로서 플립칩 성형 시뮬레이션을 개발했다(그림 2). 미세 피치 플립 칩 공정에서 야기되는 반응성 용융 고분자와 마이크로칩 콤포넌트 간에 복잡한 상호 작용으로 인해 공정 상 야기되는 기계적인 충격이나 기공과 같은 공정 문제들은 Moldex3D의 열전달과 구조적인 변형, 마이크로칩에서 언더필의 경화속도 같은 것들로부터 차별화될 수 있다. 그림 3에 도시된 바와 같이 모세관 흐름 거동은 언더필의 표면 장력에 의해 지배되며, 범프와 기판간의 접촉각, 디스펜스 공정은 모두 수치 해석화 되어진다. Moldex3D Encapsulation은 어떻게 encapsulant가 gap을 채우는지, 범프 주위의 흐름, 사출기가 움직이는 속도의 영향 등을 증명해주기 때문에 이러한 복잡한 물리적 현상을 이해하는데 더 이상 시간을 낭비하지 않게 된다. Moldex3D의 시뮬레이션 기능을 이용함으로써 프로세스 설계자는 IC 패키지의 신뢰성과 높은 성능을 보장 할 수 있다.
For more information about Moldex3D IC package solution, please proceed to read Tips and Tricks- “와이어스윕 해석” or submit your questions or comments here.