UTAC그룹은 집적 회로 분야에서 광범위한 반도체 조립 및 테스트 서비스의 선도적인 독립 업체로서 전세계 고객들에게 광범위한 범위의 패키지와 테스트 개발, 엔지니어링 및 제조 서비스와 솔루션을 제공한다.
IC 산업에서의 도전 과제는 항상 더 작고 더 얇은 패키지를 개발하는 것이다. Flip chip 패키지는 높은 input/output 특성, 더 향상된 성능 및 소형화 때문에 수년간 산업계에서 중요하게 쓰여져왔다. Flip chip기술은 다른 고밀도 전자 패키징 방식보다 다양한 면에서 우위를 차지하고 있지만, 성형성 확보라는 측면과 함께, bump pitch를 줄이기, stand-off height, thinner package profiles, molded underfill 재료 등과 같은 기술의 급속한 발달과 함께 결함을 최소화하는 등의 당면 과제가 떠오르고 있다. 복합성은 이러한 요소와 패키지 수율, 안정성 및 성능에 상호 영향을 미치는 것이다. Die 아래 bump 구간의 간격이 점점 더 작아지기 때문에, 용융 선단의 불균형과 흐름 지체를 유발하는 에어 트랩에 대한 문제가 고려되어야 한다.
UTAC은 2009년부터 가상 성형 시험 연구소를 설치하여 Moldex3D를 운용하고 있다. 이를 통해 수많은 과제들에 성공적으로 적용하고 있다.
“생산에 직면한 문제들을 Moldex3D시뮬레이션을 통해 해결하는 것에 목표를 두고 있다.” 라고 팀장인 Ore Siew Hoon은 말하고 있다. 아울러 “성형에 관련한 문제들을 해결하는 실험계획법은 그 특성상 굉장히 복잡할 수 밖에 없는데, 이는 봉합제의 유체 흐름, 열전달, 그리고 중합간의 복잡한 상호 작용에 기인하고 있다. 성형 해석은 이러한 복잡한 물리적인 현상을 분석하는데 아주 효과적인 도구이다.”라고 덧붙여 말하고 있다. 최근에 이 회사의 기술 논문이 IMAPS 심포지엄에서 44번째로 최우수 논문으로 선정되어 수상하였다. The PDF file is available for reference here.
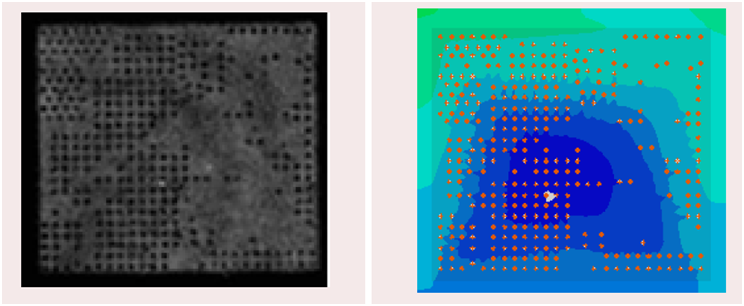 Moldex3D를 통해 molded underfill 패키지에서 발생되는 에어 트랩을 정확히 예측할 수 있다.
Moldex3D를 통해 molded underfill 패키지에서 발생되는 에어 트랩을 정확히 예측할 수 있다.