양생 분석을 사용하는 이유
후반 양생(Post Mold Cure, PMC) 공정은 웨이퍼 패키징 성형에 있어 매우 중요한 단계 중 하나입니다. 이 공정은 제품을 온도 상승 환경에 위치시켜 에폭시 수지의 양생을 가속화하고 재료의 물리적 특성을 개선합니다. 후반 양생 과정에서 에폭시 수지는 중합 변화, 화학 변화, 그리고 물리적 양생 단계를 거칠 수 있습니다. Moldex3D 후반 양생 기술에서, 데이터 유한 원소법 통합 PvTC와 온도-양생-점탄성 이완 통합형 모델을 통해 완벽한 후반 양생 과정을 시뮬레이션합니
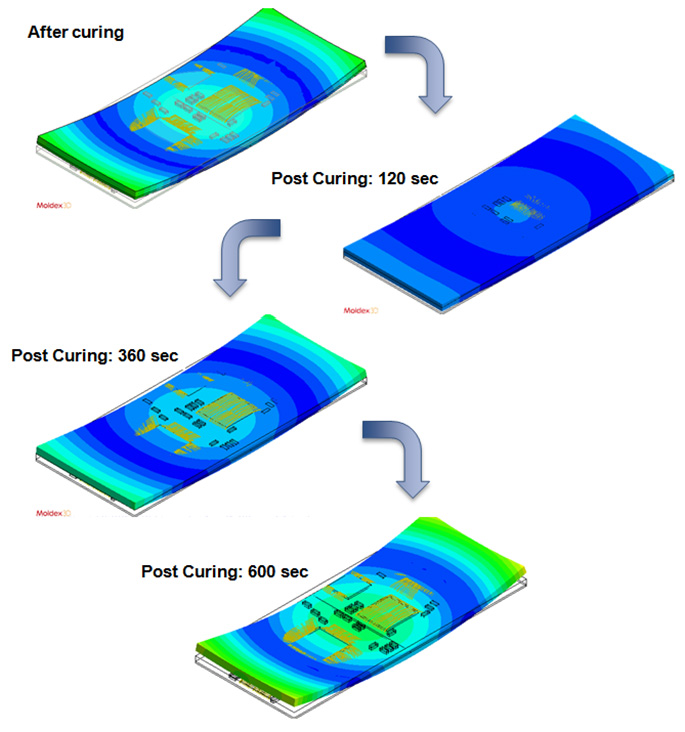
도전
- 2차 굴곡의 최종 변형 상황 예측
- 성형 과정에서 다양한 재료 CLTE 특성과 양생 수축 변화의 영향으로 인해 발생하는 기존 응력(Inherent Stress)을 효과적으로 낮춤
Moldex3D 솔루션
- 잠재적인 변형 문제를 예측
- 성형 과정 중 금형 캐비티 안에서의, 그리고 금형 분리 후의 양생 결과를 시뮬레이션
- 양생을 거쳐 만들어지는 잔류 응력과 열 잔류 응력을 고려
응용 분야
IC Packaging 웨이퍼 패키징 산업
Moldex3D 추천 제품
Moldex3D Advanced Package