Perplexed by challenges and uncertainty in the chip encapsulation process?
Look no further! Moldex3D IC Packaging is your lifesaver.
Incomplete filling, internal voids, wire sweep, and paddle shift are common defects in IC package. Predict them in the early stages to reduce manufacturing cost and cycle time!
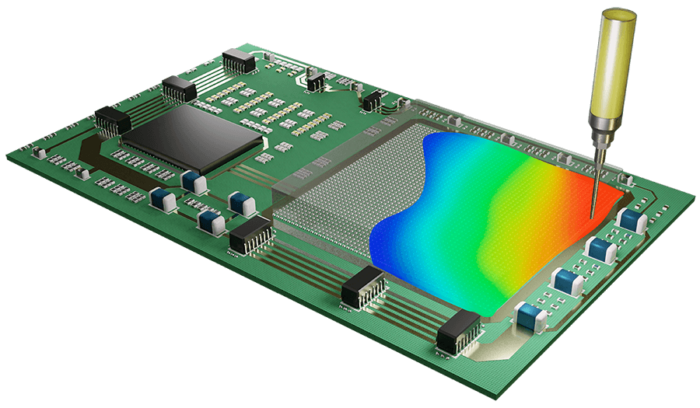
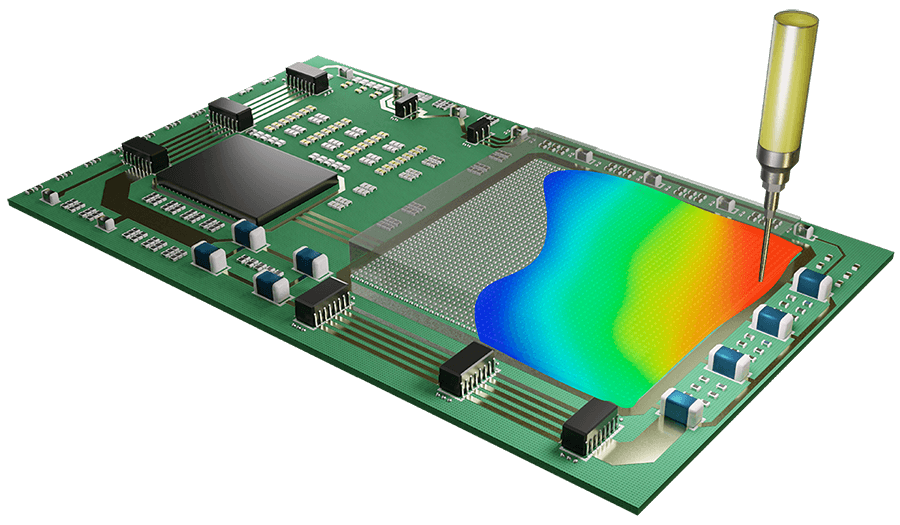
Why Moldex3D IC Packaging?
Moldex3D IC Packaging provides thorough 3D solutions that help you analyze the complicated physical phenomena inherent in the encapsulation process.
With Moldex3D IC Packaging, you’ll benefit from:
- Visualization of the filling and curing processes and other characteristics
- Package and mold design validation and optimization
- Simulation-driven design addressing complex fluid-structure interactions
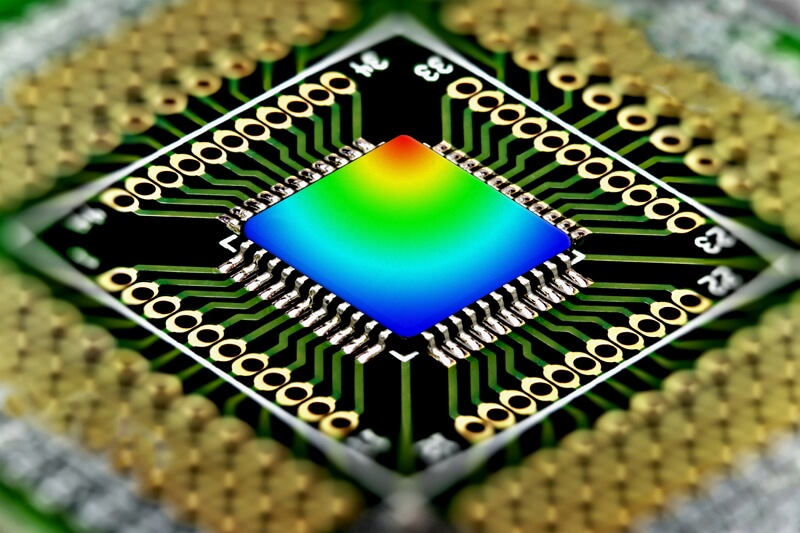
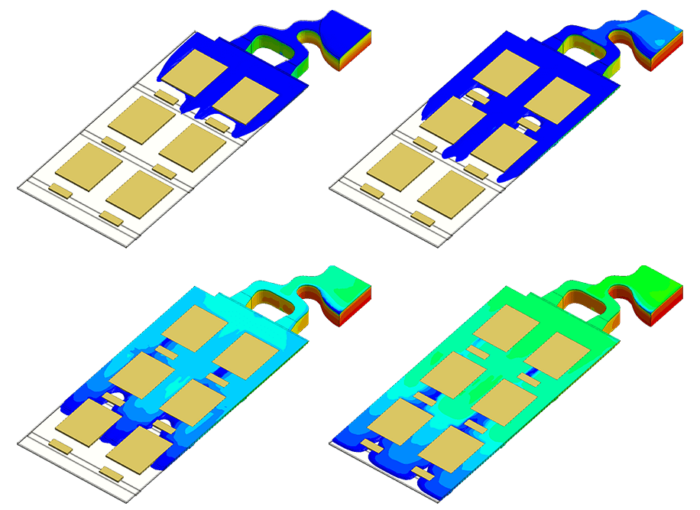

What Moldex3D IC Packaging can offer?
Moldex3D IC Packaging currently offers comprehensive support for analysis, ranging from basic flow filling and curing process to other advanced manufacturing evaluations.
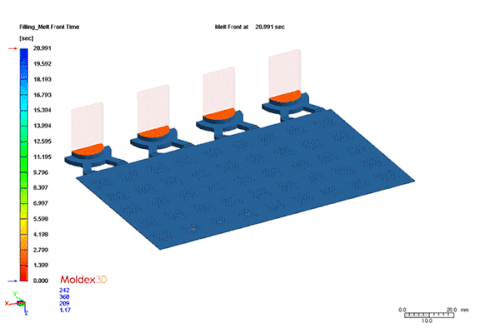
Molded Underfill Simulation
- Optimize the gate and runner designs
- Visualize filling and curing processes
- Calculate the pressure drop inside the air zone to optimize the air vent design
- Evaluate the process conditions and material properties
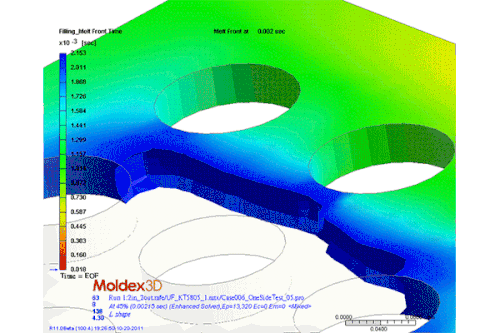
Capillary Underfill Simulation
- Visualize capillary-force-induced filling behavior with different surface tension and contact angle
- Evaluate the flow effects due to bump pitch and bump pattern
- Optimize the dispensing setting for capillary underfill process
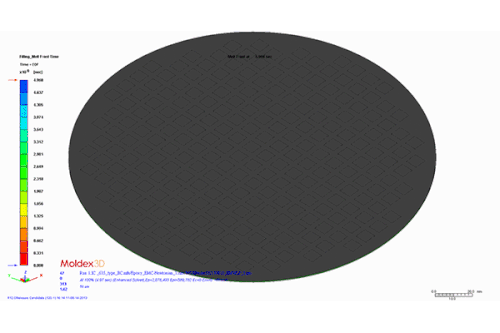
Compression Molding
- Visualize dynamic melt flow front during compression molding process
- Evaluate warpage, shear stress distribution, and die shift for Fan-out package
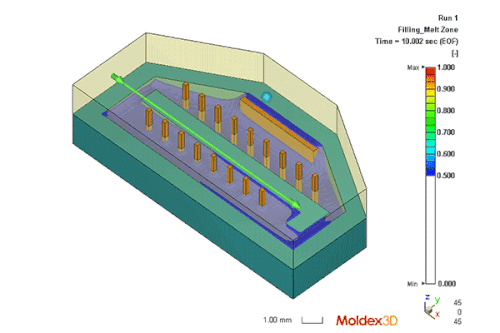
Potting
- Visualize dispenser pass and feeding in a more realistic and detailed way
- Simulate surface tension induced behaviors such as creeping
Customer Success Story
Challenges
- Improving the unbalanced flow behavior
- Reducing weld lines and voids
Moldex3D Solutions Used
- Moldex3D IC Packaging
Benefits
- Identifying locations where weld lines tend to appear
- Downsizing weld line meeting angles
- Lowering the probability of void formation
Challenges
- Minimize the area that occurs void
Moldex3D Solutions Used
- Moldex3D IC Packaging
Benefits
- Anticipate possible molding defects, such as the location of voids
Challenges
- Reducing the incomplete filling
- Improving warpage performances
Moldex3D Solutions Used
- Moldex3D IC Packaging
Benefits
- Design optimization can enhance flow balance
- Lowering voiding problems
Contact Us Now
Copyright © 2024 Moldex3D. All rights reserved. | Privacy Policy