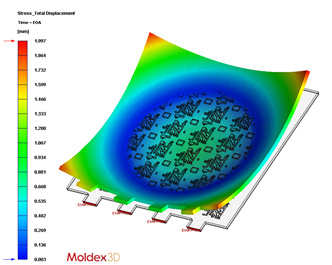
Moldex3D IC Packaging Stress
Stress Analysis has been mainly applied for designers to observe stress distribution inside parts and part inserts. The stress distribution has a significant impact on part quality and structural strength, influenced by many molding factors, including temperature, force, part shape and size, material properties, etc. The stress over safety loading may destroy structural strength and cause breakage on the part. Therefore, obtaining accurate stress analysis results upfront is crucial for designers to reduce fatigue failure and extend product life cycle.
Capabilities
- Predicts potential deformation problems to evaluate material properties and process conditions
- Predicts the displacement of inserts due to non-uniform flow-induced pressure with accurate 2-way Fluid Structure Interaction (FSI) consideration for Core Shift behavior of MCM, as well as Wire Sweep and Paddle Shift behaviors of IC Packaging
Features
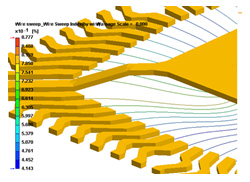
Wire Sweep simulation
- Observe the wire deformation at different scales
- Complete wire sweep results inspection provides detailed deformation behaviors
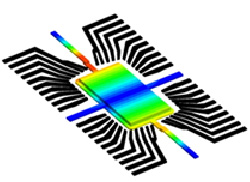
Paddle Shift Simulation
- Separate total displacement into x-axis, y-axis, and z-axis
- Shear Stress and Von Mises Stress are also displayed
- Support Scale up the paddle deformation

FSI Simulation (for Paddle shift)
- Considers fluid-structure interaction
- Two-way FSI and one-way FSI are the options which user could choose in paddle shift analysis of Moldex3D
Post Mold Curing Simulation
- Predict potential deformation problems.
- Simulate both the in-mold and post-mold curing effect during molding process