芯片经过封装程序后,金线间的距离不会与原始设计相同,相互接触的金线则会造成短路,故设计封装流程中应避免金线大幅度的偏移。Moldex3D R13.0 新功能可分析出金线偏移结果,以利使用者掌握其偏移程度。
步骤 1: 金线偏移分析的前置设定:在计算参数(Computation Parameter)的封装(Encapsulation)中,使用者须选定Moldex3D作为应力分析的Solver。除了Moldex3D Solver之外,Moldex3D分析系统也支持其他应力分析软件如ANSYS 及ABAQUS。若用户须进行进一步的分析,则可以选择ANSYS及ABAQUS作为应力分析的Solver。
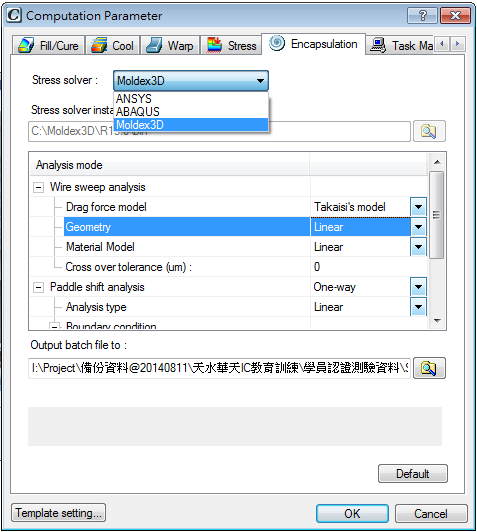
步骤 2: 在分析序列中,须选择金线偏移分析(Wire Sweep)以进行分析。完成后,和最近金线距离(Distance to Closest Wire) 和最近金线距离(依金线)(Distance to Closest Wire (by wire))分析结果会如下图显示于Wire Sweep 结果内。


步骤 3:
1. 和最近金线的距离:
取各金线节点与最邻近金线之最小距离,利用色阶显示其在金在线的分布,使用者可判别其可能发生短路的位置。

2. 和最近金线的距离 (依金线):
取单一金线与最邻近金线之最小距离,利用色阶显示于全部金线,使用者可以用以判断各金线发生短路的严重程度。