IC Insights’ 2012 McClean Report 指出 “IC 封装不再让前端制程专美于前…封装已从简易如切割饼干般的封装切割技术演变成高度复杂且客制化的解决方案”,而这似乎也反映在近期的产业趋势上,半导体制造商积极抢进封装领域,面对3D IC技术崛起,预测未来封装的支出将会不断成长。
晶圆级封装技术带来的优势,让半导体晶圆厂投注相当多的资源和研究在3D IC 制程上;另一方面,由于全球芯片需求量大增,传统半导体设备组装厂也开始专注在3D IC制程上。
3D IC技术具备多项优势,例如:可有效提升芯片效能、降低功耗、更多储存容量、更大的带宽以及较小的尺寸。然而3D IC制程存在温度和可靠度的问题,举例来说:微电子组件塑料封装技术中用来保护硅片、锡铅凸块、打线、导线架和底座的环氧成型模料,可能会造成变形以及不必要的缺陷。
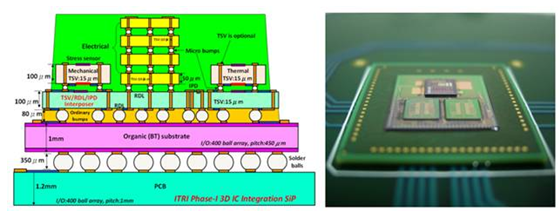 图一 3D IC 构造图 (来源:ITRI, Electronics and Optoelectronics Research Laboratories)
图一 3D IC 构造图 (来源:ITRI, Electronics and Optoelectronics Research Laboratories)
Moldex3D 专精于研发并提供封装制程问题解决方案已行之有年,Moldex3D芯片封装模块能精准预测金线偏移、残留应力、空孔等问题,由于3D IC 封装产业需求日益遽增,Moldex3D 也推出覆晶封装解决方案,该方案为一强大并可检视3D IC封装制程可靠度的工具(请见图二)。在细微的锡球间距中,覆晶制程封装材料其流动及硬化反应可能带来一些问题,像是受反应放热或机械应力影响的缺陷及空孔等,而利用Moldex3D仿真分析软件,皆可轻易地诊断出覆晶芯片中热传导、结构变形以及硬化反应所带来的问题。
Moldex3D 不但可以模拟覆晶封装制程中的毛细管流动行为,在模拟底胶的流动行为时,更可将填胶方式、锡球和基板间的接触角等重要因素纳入分析要点中。Moldex3D芯片封装模块能将封胶如何充填以及如何在锡球间流动一一真实呈现,制程设计者将可省下了解这些复杂物理现象所需的时间,藉由Moldex3D强大的模拟分析能力,制程相关人员将可以确保IC封装的可靠度和高效能。
更多关于Moldex3D 提供IC封装仿真的功能,请继续阅读2012第十一期电子月刊中的产品技巧专栏”如何使用Moldex3D完成金线偏移量分析,或与我们联系。