應力分析已被應用於分析晶片在封裝成型過程所受到的應力。 應力分佈對產品質量和結構強度具有顯著影響,其中幾項因素,包括 : 環境溫度、力、產品幾何、產品尺寸與材料特性等。倘若產品承受的應力量值超過安全負載的範圍,可能會造成結構強度衰減並導致產品破壞或斷裂。因此,準確的應力分析結果對於晶片封裝來說是一項極為重要結果項目;透過修正可以進一步減少疲勞應力和延長產品生命週期。
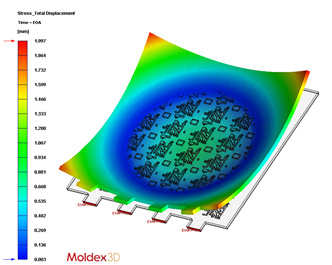
Moldex3D晶片封裝應力分析
功能
- 預估潛在的變形問題,藉以評估適合的材料特性與成型條件
- 透過雙向流固偶合分析可預測IC封裝組件(Insert)受到非均勻流動所產生的壓力推擠產生的偏移;同時應力分析也可預估金線偏移與導線架偏移的行為
特色
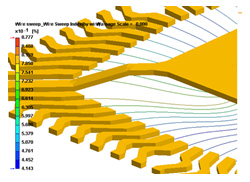
金線偏移分析
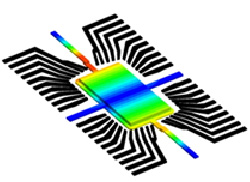
導線架偏移

流固耦合FSI分析 (僅適用導線架偏移)
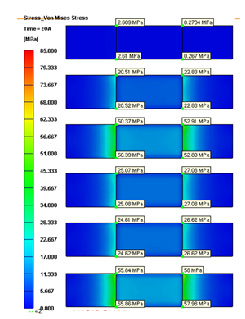
後熟化分析