為什麼使用後熟化分析?
後熟化(Post Mold Cure, PMC)流程在晶片封裝成型中是相當重要的一環。此製程將產品放置於升溫環境中,藉以加速環氧樹脂的熟化及優化材料物理特性。在後熟化過程中,環氧樹脂將會經歷聚合變化、化學變化及物理熟化的步驟。在Moldex3D後熟化技術中,是透過數值有限元素法整合PvTC與溫度-熟化-粘彈性鬆弛整合式的模型模擬完整後熟化過程。
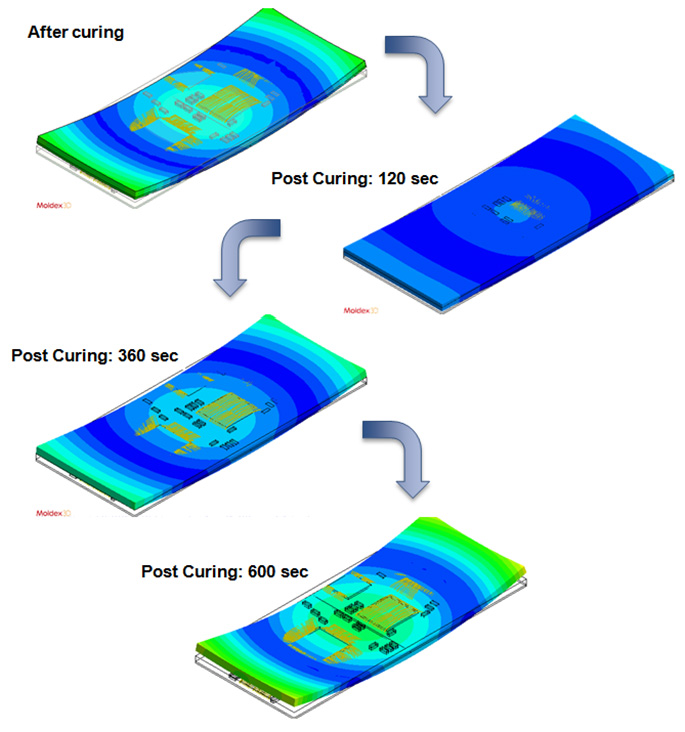
挑戰
- 預測二次翹曲的最終變形情況
- 如何將成型過程中,因不同的材料CLTE特性與熟化收縮變化影響所產生的既有應力(Inherent Stress)有效降低?
Moldex3D 解決方案
- 預測潛在的變形問題
- 模擬成型過程中的模腔內和離模後熟化結果
- 考慮熟化過程產生的殘餘應力和熱殘餘應力
應用產業
- IC Packaging 晶片封裝產業
Moldex3D建議產品
- Moldex3D Advanced Package