大部分的EDA軟體工具在處理IC 電路、IC封裝、或電路板等佈局工作上,一般都是二維的呈現,而此呈現方式對於基板佈局、接點連結及 基板佈局、電路互聯設計、及金屬構件設計方面可能是足夠。然而,近來IC封裝逐漸朝向更複雜與精密的設計趨勢,利用真實三維軟體來呈現IC封裝模擬驗證更能貼近實際的IC 封裝需求、方便管理與驗證多層晶片金線結合或堆疊晶片的產品設計。
Cadence® Connections™ EDA Program與來自世界各地第三方軟體供應商合作以求發展全面的IC解決方案,進而提升用戶的使用經驗與產品價值。此Cadence方案提供互補解決方案,予希望能在前端設計時便能驗證IP、IC信號混合之系統級封裝及電路板製造和封裝系統的供應商。Cadence EDA工具幫助IC封裝設計人員事先洞悉IC在實際封裝階段可能發生狀況。其IC 封裝設計得以3D視圖方式呈現,而且IC設計人員可以依自己的需求自由縮放、平移和旋轉其3D視圖[1] 。
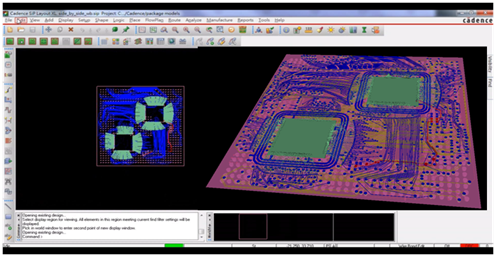 圖一 Candence EDA工具幫助事先洞悉IC在實際封裝階段可能發生狀況
圖一 Candence EDA工具幫助事先洞悉IC在實際封裝階段可能發生狀況
Moldex3D IC封裝模擬分析模組,目前成功與Cadence EDA用戶介面整合,透過創新並專業的3D IC封裝模擬技術,以進一步全面提升IC封裝設計至生產的整體過程。此嶄新的整合介面提供使用者直接導入.3di file檔案至Moldex3D Designer網格前處理的整合功能,即使是複雜的IC封裝設計檔案都能輕鬆的導入處理。所有的元件皆能無縫地導入於Moldex3D Designer,接著透過Moldex3D自動、高效能的網格生成器能有效生成IC封裝的完整網格,減少因網格製作困難而需簡化產品幾何的步驟,完整保留幾何網格以提供更精確的模擬分析。此外,參數化之設定功能,可以有效生成精細的IC封裝分析網格,讓使用者在網格準備上大大的節省了時間和精力。
此外,Moldex3D可以計算非線性的熔膠流動行為,如樹脂材料在模內及後熟化製程中的中的黏度變化。 使用者事先得以預測顯著成型問題並有效預防問題的發生,這有助於防止潛在的缺陷的發生以進而提升封裝晶片的品質[2]。

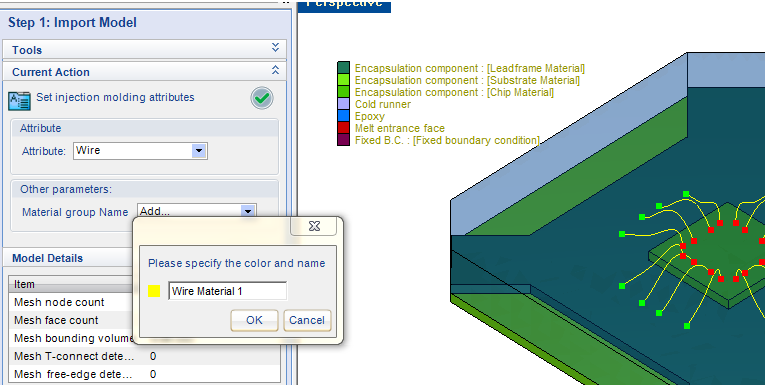 圖二 使用者可直接導入.3di file檔案於Moldex3D網格前處理器,並且透過參數化之設定功能,有效生成精細的IC封裝分析網格
圖二 使用者可直接導入.3di file檔案於Moldex3D網格前處理器,並且透過參數化之設定功能,有效生成精細的IC封裝分析網格
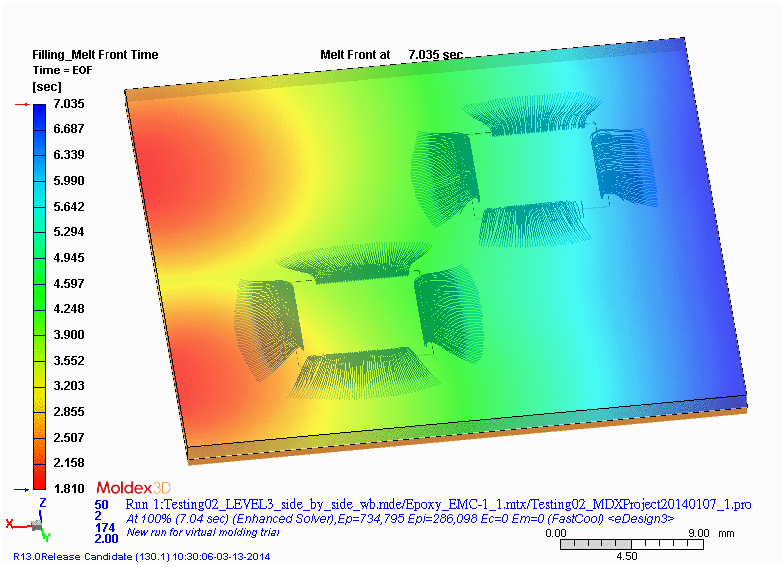 圖三 Moldex3D IC 封裝真實三唯模擬技術幫助使用者成功事前預測潛在成型缺陷
圖三 Moldex3D IC 封裝真實三唯模擬技術幫助使用者成功事前預測潛在成型缺陷
[1] https://www.cadence.com/products/pkg/3d_design_viewer/pages/default.aspx[2] https://www.youtube.com/watch?v=nj3ltW7Ax1c